底部填充封裝點膠機帶來哪些影響?
隨著手機、電腦等便(biàn)攜式(shì)電子產品的發展趨向薄型化(huà)、小型化、高性能化,IC封裝也(yě)趨向小型化、高聚集化方向(xiàng)發展。而底部封裝點膠工藝可以解(jiě)決精密電子元(yuán)件的很多問題,比如BGA、芯(xīn)片不穩定,質量不老(lǎo)牢固等,這也使得underfill底部填充(chōng)工藝隨著發展而更(gèng)加受歡迎。
精密電子芯片元件會遇到哪些問題呢?
BGA和CSP是通(tōng)過錫球固定在線路板上,存在熱應力、機械應力等應力集中現象,如果受到衝擊、彎折等外力作用,焊接部位容(róng)易發生斷裂。此外,如(rú)果上錫太多以至於錫爬到(dào)元件本體,可能導致引(yǐn)腳不能承受熱應力和機械應力的影響。因此芯片耐機(jī)械衝擊和熱衝擊性比較差,出現產品易(yì)碎、質量不過關等問題。
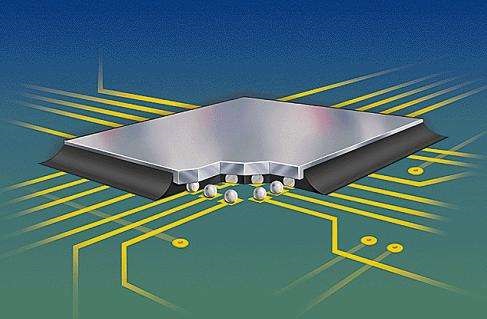
相關解決方案:
高精度的(de)電子芯片,每一個元件都極其微細且關鍵,為了穩定BGA,需要多一(yī)個底部封裝步驟,高精(jīng)密點膠(jiāo)機非接觸式(shì)噴射點膠機設備(bèi)可實現精密(mì)芯片的底部填充封裝工藝(yì)。隨著技術的更(gèng)新(xīn)發展,和針對電子芯片穩定性和質量(liàng)存在的問題(tí),底部填充封裝工藝便開始得到推廣(guǎng)和應用,並獲得非常好的效果。由於使用(yòng)了噴射式點膠機進行underfill底部填充膠的芯片在跌落測試和高低溫(wēn)測試(shì)中(zhōng)有優異(yì)的表現,所以在焊球(qiú)直徑小、細間距焊點(diǎn)的BGA、CSP芯片組裝中,都(dōu)要使用底部填充膠進行底部補強。
底部填充封裝點(diǎn)膠機(jī)帶來的優勢:
歐力克(kè)斯底部填充膠點膠機(jī)undfill封裝(zhuāng)應用,可以分散降(jiàng)低焊球上的應力,抗形變、耐彎曲,耐高(gāo)低溫(wēn)-50~125℃,減少芯片與基材CTE(熱膨脹係數)的差別,能有效降低由於矽芯片(piàn)與基(jī)板之間的總體溫度膨(péng)脹特性不匹(pǐ)配或外力造成的衝擊。
非接觸噴射點膠機底部填(tián)充工藝的應用,底部填充膠受熱固化後,可提高芯片連接後的機械結構強度(dù),使得產(chǎn)品穩定性更強!
更多底部(bù)填充封裝點膠工藝和底部填充點膠機設備等相(xiàng)關信(xìn)息,歡迎來訪谘詢歐力克斯。
同類文章推薦
- 機器(qì)視覺自動化重述未來
- 什麽是物聯網 (IOT)?
- 什麽是數字(zì)製(zhì)造?
- 什麽是工業5.0?
- 5G 智能工廠 | 沒有數字化轉型(xíng)戰略的公司已經落後於(yú)競爭對手
- 5G與未來(lái)智能工廠:5G將如何影(yǐng)響工廠自動化(huà)
- 智能工廠的(de)四個層次
- 現代汽車 | 智能工廠:創造性破壞帶來的(de)價值鏈(liàn)創新
- 什麽是(shì)工業 4.0?
- 什麽是智能工(gōng)廠?
最新資訊(xùn)文(wén)章
您的瀏覽曆史









