半導(dǎo)體芯片底部填充點膠機填充方式
隨著人工(gōng)智能產業、智(zhì)能製造越來越普遍,智能產(chǎn)品不斷湧現,全世界芯片(piàn)產業規模在不斷(duàn)擴大,半導體芯片幾乎遍布所有產品(pǐn)。芯片的生(shēng)產有芯片設計、晶片(piàn)製作、封裝製作、測試等幾個環節,而(ér)芯片封(fēng)裝工藝尤為關鍵。
據了解,關於芯片封(fēng)裝(zhuāng)過程中BGA不良率(lǜ)約6%,無法再次返修的板卡比例為90%,而掉點的位置大部分分布在四邊角處,原因基本分(fèn)析(xī)為受散熱片應力、現場環(huán)境有震動、板卡變形應力等引起。
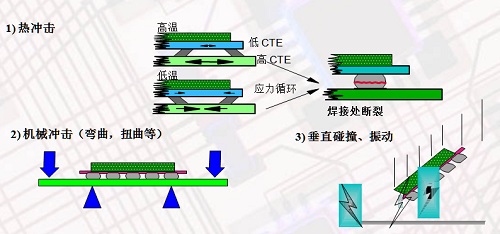
一、高標準“中國芯”
智能芯片的廣泛(fàn)應用,而良品率的產能卻沒有得到質的飛躍。在芯片的生產中,高(gāo)質量底部填充封裝工藝也是實現高標(biāo)準高要求“中(zhōng)國(guó)芯”的重要影(yǐng)響因素之一,以下內容為晶圓級芯片產品的底部填充工藝要求:
1、操作性及效率性方麵要求:對芯(xīn)片底部填充速度、膠水固化時間和固化方式以及返修性的高要(yào)求。
2、功能性方麵要求(qiú):填(tián)充效果佳,不出現氣泡(pào)現象、降低空(kōng)洞率,以及提高芯片抗跌震等性能要求(qiú)。
3、可靠性方麵要求:芯片質量密封性、粘接程度,以及表麵絕緣電阻、恒溫恒濕、冷熱衝擊等方麵的合格效果。

二(èr)、高質量底部填充(chōng)方式
晶圓級芯片underfill底部(bù)填充工藝(yì)的噴射塗布方式非常講究,可以通過噴射閥實現高速、精密填充效果。一般有這三種底部填充方式(如下圖所示),底部填充膠因毛細管(guǎn)虹吸作用按箭頭方向自動填充,常見的填充(chōng)方式有“一”型(xíng)和“L”型,“U”型作業;通過一(yī)型、L型、U型點膠路徑下的流動(dòng)波前分析,U型的填充(chōng)時間最小為2.588s,I型填充時間最(zuì)長為3.356s,L型的填充時間為2.890s。
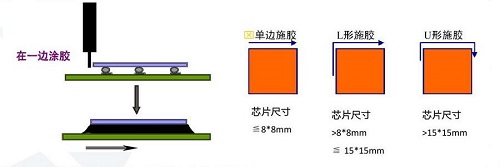
由於芯片下方有(yǒu)solder bump,填充膠在流動(dòng)過程中流經solder bump時由於阻力作用,導致填充膠在solder bump密集的地方(fāng)要比稀疏的地方要流動要(yào)慢,容易出(chū)現底部填充不完全,出現空洞的現象。所以噴射式(shì)點膠機在使(shǐ)用時需要根據芯片實際情況選擇合適的底部填(tián)充路徑,以減少生產工藝中的缺陷,提高產品質量(liàng),減少生(shēng)產成本。
深圳精密點膠設備專(zhuān)業製(zhì)造商歐力克斯(sī)的噴射式點膠機,采用自主研發的CCD視覺軟(ruǎn)件係統,並搭載德國高(gāo)精度噴射(shè)閥,實現點膠精密化(huà)精準化效果。

噴射係(xì)列(liè)點膠機可實現精(jīng)美的半導體底部填充封裝、LED封裝、LCD封裝、SMT元(yuán)器件(jiàn)點塗、連接器點膠粘接(jiē)、相機模組封裝、錫(xī)膏塗布等工(gōng)藝,可有效提升芯片與基板連接的作用,從而提(tí)高元器件結構強度,有效保障芯(xīn)片係統的高穩定性和高可靠性,延長其使用壽命。

深圳市歐力克斯科技有限公司精密點膠設備專業智造商,不斷鑽研(yán)控膠技術,挑戰精密元件點膠封裝控製工藝,歐(ōu)力(lì)克斯自主研發生產的噴射係列精密點膠機,趨近(jìn)於國際點膠技術水(shuǐ)平,可實現(xiàn)高要求芯片(piàn)底部填充封裝粘接,提高產(chǎn)品性能保證質量。
同類文章推薦
- 機器視覺自(zì)動化重述未來
- 什麽是(shì)物聯網(wǎng) (IOT)?
- 什麽是數字製造?
- 什(shí)麽是工業5.0?
- 5G 智能(néng)工廠 | 沒有數(shù)字化轉型戰略的公司已經落(luò)後於競爭對手
- 5G與(yǔ)未來智能工廠:5G將如(rú)何影(yǐng)響(xiǎng)工廠自動(dòng)化
- 智能工(gōng)廠的四個層次
- 現代汽車 | 智能工廠:創造性破壞帶(dài)來的價值鏈(liàn)創新
- 什麽是工(gōng)業 4.0?
- 什麽是智能工廠?
最新資訊文章
您(nín)的(de)瀏覽曆史









