underfill芯片半導體底部(bù)填充倒裝方式(shì)
正、倒裝芯片(piàn)是當今半(bàn)導體(tǐ)封裝領域的一大熱(rè)點,既(jì)是一種芯片互(hù)連技術,也是一種理想的(de)芯片粘接技術。
以往後級封裝技術都是將芯(xīn)片的有源區麵朝上,背對基板粘貼後鍵合(如引(yǐn)線鍵合和載帶自動鍵合(hé)TAB)。而(ér)倒裝芯片則是將芯片有源區麵(miàn)對基板,通過(guò)芯片上呈陣列排列的焊料凸點來(lái)實現芯(xīn)片與襯底的互連。顯然,這種正倒封裝半導體芯片、underfill 底部填充工藝要求都更(gèng)高。
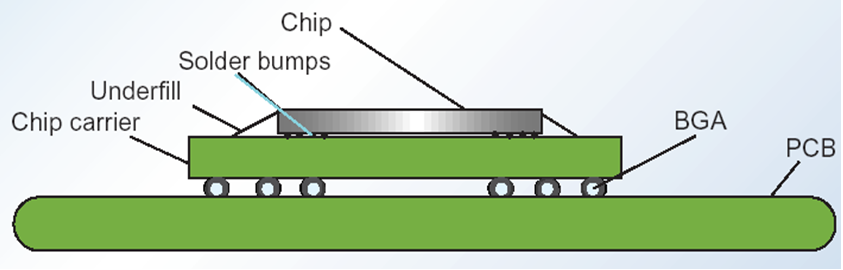
隨著半(bàn)導體的精密化精細化(huà),底部填充膠(jiāo)填充工藝需要更嚴謹,封裝技術要求更高(gāo),普通的點膠(jiāo)閥已經難以滿足半(bàn)導體underfill底部填充封裝(zhuāng)。而高精度噴射閥正是實現半導體底部填充封裝工藝的新技術產品(pǐn)。
underfill半導體底部填充工藝的噴射塗布方(fāng)式也是非常講究的,有了高速噴射閥的(de)使用,可以確保underfill半導體底部填充工藝的完(wán)美程度。底部填充膠因毛細管虹吸作用按箭頭方向自動填充。通常情(qíng)況下,不建議(yì)采用“U”型作業,通常用“一”型和“L”型(xíng),因為采用“U”型作業,通過表麵觀察的,有可能會形成(chéng)元件底部中間大(dà)範圍內(nèi)空洞。

深(shēn)圳市歐力克斯科技有限(xiàn)公司代理的德國Lerner噴射(shè)閥,適應不同粘度流體漿體,滿足底部填充膠的流動性膠水;底部填充工藝中(zhōng)需要關(guān)注的問題有兩個(gè),一個是盡量避免不需要(yào)填充的元件被填充,另一個是絕對禁止填充物對扣屏蔽罩有影響,依據這兩個原則可以確定噴塗位置,德國品(pǐn)牌Lerner非接觸式噴射閥更好的(de)配(pèi)合使用。
更多芯片半導體underfill底部填充倒裝工藝噴射封裝解決應用方案,高精度噴射閥等相關信息,歡迎來訪谘詢歐力克斯。
同類文章推薦
- 機(jī)器視覺自(zì)動化(huà)重述未來
- 什麽是物聯網 (IOT)?
- 什麽是數字製造?
- 什麽是工業5.0?
- 5G 智能工廠 | 沒有數字化(huà)轉型戰略的公司已經落後於(yú)競爭對手
- 5G與未(wèi)來智(zhì)能工廠:5G將如(rú)何影(yǐng)響工廠自動(dòng)化
- 智能工廠的四個層次
- 現(xiàn)代(dài)汽車 | 智(zhì)能工廠:創造性破壞帶來的價值鏈創新
- 什麽是工業 4.0?
- 什麽是智能工廠(chǎng)?
最新資訊文章
您的瀏覽曆史









